什么是 Bumping(凸块技术)?
Bumping,中文常译为“凸块技术”或“植球技术”,是指在芯片的焊盘上,通过特定的工艺方法,制作出微小的、凸起的金属球或柱状连接结构。
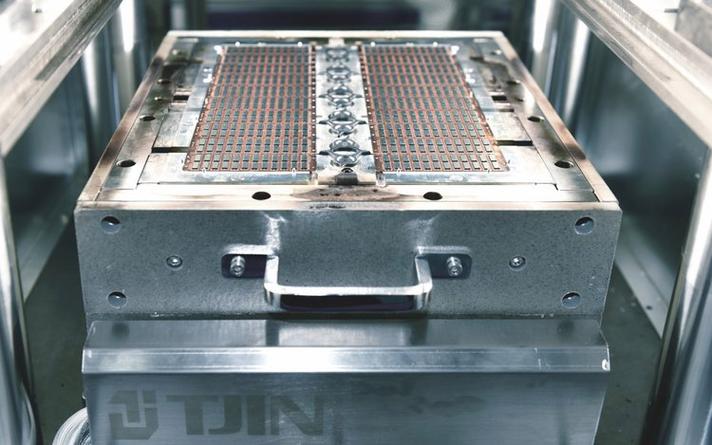
您可以把它想象成:
- 给芯片的“脚”(焊盘)穿上“增高鞋”或“戴上小帽子”。
- 在芯片和基板之间搭建一座座微型的“金属桥梁”。
这些微小的“凸块”不仅仅是物理上的连接点,它们更是实现芯片与外部世界(如封装基板、印刷电路板PCB或其他芯片)进行电气连接、机械支撑和热量导出的关键媒介。
为什么需要 Bumping?(核心作用)
在芯片制造中,硅片本身是绝缘的,其电路功能通过金属层(通常是铝或铜)连接到芯片表面的焊盘上,这些焊盘非常小且脆弱,无法直接用于焊接,Bumping技术解决了以下几个核心问题:
-
电气连接:
 (图片来源网络,侵删)
(图片来源网络,侵删)- 功能: 凸块是芯片内部电路与外部封装基板/PCB之间的“电流通道”,当芯片通过倒装焊等技术与基板对准并加热后,凸块会熔化并形成可靠的电气连接,将芯片的信号、电源和地线引出。
- 重要性: 没有凸块,芯片的电路功能就无法与外界通信。
-
机械支撑:
- 功能: 凸块在芯片和基板之间提供了物理支撑,形成一个微小的间隙(称为Underfill(底部填充胶)的填充空间),这可以有效缓冲芯片在受到热胀冷缩、振动或冲击时产生的应力,保护芯片内部的精细电路不被损坏。
- 重要性: 提高了整个封装组件的机械可靠性和耐用性。
-
热量导出:
- 功能: 凸块通常由高导热性的金属(如金、铜、锡银合金)制成,它们可以充当“热通道”,将芯片工作时产生的大量热量高效地传导到封装基板(如硅通孔TSV基板、有机基板),最终散发到空气中。
- 重要性: 随着芯片集成度越来越高,功耗和发热量急剧增加,凸块的散热功能对于保证芯片稳定运行、延长寿命至关重要。
Bumping 的主要工艺类型
根据凸块材料、尺寸和工艺的不同,Bumping技术主要分为以下几类:
a. 焊料凸块
这是最传统、最广泛使用的技术,材料通常是锡铅合金或无铅焊料(如锡银铜合金,SAC)。
- 工艺:
- UBM(Under Bump Metallurgy,凸块下金属层)沉积: 在芯片焊盘上先溅射或电镀一层多层金属(如Ti/Cr/Cu),用于增强焊料与硅片之间的粘附力和防止氧化。
- 光刻: 像照相机一样,在UBM层上覆盖一层光刻胶,通过曝光、显影,只留下需要制作凸块的区域。
- 凸块制作: 在开口中电镀焊料,形成焊料凸点。
- 去胶和蚀刻: 去除光刻胶,并蚀刻掉暴露在外的UBM层,留下孤立的焊料凸块。
- 特点:
- 优点: 工艺成熟、成本相对较低、具有良好的熔融自对准特性(回流时能自动对准焊盘)。
- 缺点: 凸块尺寸受限于焊料的流动性,难以做到非常精细(通常大于50微米)。
b. 金凸块
主要应用于高可靠性领域,如陶瓷柱栅阵列封装。
- 工艺: 与焊料凸块类似,但最终电镀的是纯金。
- 特点:
- 优点: 耐腐蚀性极好、导电导热性能优异、可靠性高。
- 缺点: 成本非常高,无法通过熔融回流进行连接,通常需要使用助焊剂和高温热压。
c. 铜柱凸块
这是目前先进封装领域的主流技术,是应对高密度、高I/O(输入/输出)需求的革命性技术。
- 工艺:
- 在UBM上电镀一个铜柱作为核心支撑结构。
- 在铜柱的顶部电镀一层薄薄的焊料帽。
- 特点:
- 优点:
- 高密度: 铜柱本身尺寸可以做得非常精细(小于20微米),且间距更小,极大地提高了I/O密度。
- 低电容: 铜柱是实心的,与焊料凸块相比,其寄生电容更低,有利于提高信号传输速度。
- 散热更好: 铜的导热性优于焊料,铜柱能提供更直接的热传导路径。
- 电迁移抗性强: 在大电流应用下,铜比焊料更不容易发生电迁移失效。
- 缺点: 工艺流程比传统焊料凸块更复杂,成本也更高。
- 优点:
d. 复合凸块
为了结合不同材料的优点,出现了复合凸块,在铜柱凸块的顶部再电镀一层镍金层,用于后续的键合和防腐蚀。
Bumping 的典型应用流程(以倒装焊为例)
Bumping技术最经典的应用场景是倒装焊。
- 芯片制造: 在晶圆上完成芯片的电路制造。
- Bumping工艺: 在整片晶圆的I/O焊盘上制作好凸块(如铜柱凸块)。
- 切割: 将带有凸块的晶圆切割成独立的芯片。
- 倒装: 将芯片翻转过来,使凸块朝下。
- 对准与键合: 将芯片精确地对准到封装基板上对应的焊盘,然后加热使凸块顶部的焊料熔化,与基板形成永久性连接。
- 底部填充: 在芯片和基板之间的缝隙中注入环氧树脂胶,固化后提供机械支撑。
- 后续封装: 进行塑封、引线键合(如果需要)、打标、测试等最终步骤。
Bumping 的重要性与未来趋势
Bumping技术是连接裸芯片和封装世界的桥梁,它不再是简单的“焊点”,而是集成了电气、机械、热管理等多重功能的核心构件。
其重要性体现在:
- 是先进封装的基石: 没有高密度、高可靠性的Bumping技术,就没有5D/3D封装、扇出型封装等先进封装形式。
- 决定芯片性能极限: 凸块的密度、尺寸和材料直接决定了芯片的I/O数量、信号传输速度和散热能力,进而影响整个芯片系统的性能。
未来趋势:
- 更小尺寸: 随着摩尔定律和超越摩尔定律的发展,凸块间距和尺寸将持续缩小,向微米甚至亚微米级别迈进。
- 新材料: 除了铜柱,低熔点合金、纳米银烧结等新材料和工艺也在不断涌现,以满足更高性能和更低热预算的需求。
- 高密度集成: Bumping技术是实现芯片堆叠和异构集成的关键技术,是未来AI、高性能计算等领域发展的核心驱动力之一。
Bumping技术是半导体封装领域一项不可或缺的、持续创新的“点金术”,它为芯片赋予了“生命”和“力量”,是支撑整个电子信息产业发展的幕后英雄。